失效分析測試設備都有哪些及設備失效分析流程返回列表
1 C-SAM(超聲波掃描顯微鏡),無損檢查:1.材料內部的晶格結構,雜質顆粒.夾雜物.沉淀物.2. 內部裂紋. 3.分層缺陷.4.空洞,氣泡,空隙等. 德國
2 X-Ray(這兩者是芯片發生失效后首先使用的非破壞性分析手段),德國Fein
微焦點Xray用途:半導體BGA,線路板等內部位移的分析 ;利于判別空焊,虛焊等BGA焊接缺陷. 參數:標準檢測分辨率<500納米 ; 幾何放大倍數: 2000 倍 最大放大倍數: 10000倍 ; 輻射小: 每小時低于1 μSv ; 電壓: 160 KV, 開放式射線管設計
防碰撞設計;BGA和SMT(QFP)自動分析軟件,空隙計算軟件,通用缺陷自動識別軟件和視頻記錄。這些特點非常適合進行各種二維檢測和三維微焦點計算機斷層掃描(μCT)應用。
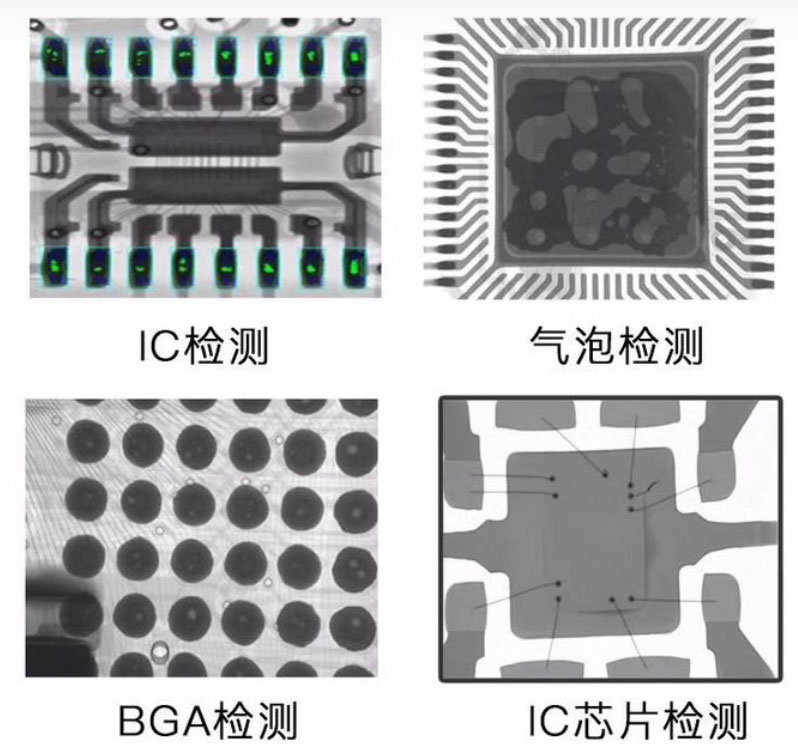
Fein微焦點X射線(德國)
Y.COUGAR F/A系列可選配樣品旋轉360度和傾斜60度裝置。
Y.COUGAR SMT 系列配置140度傾斜軸樣品,選配360度旋轉臺
3 SEM掃描電鏡/EDX能量彌散X光儀(材料結構分析/缺陷觀察,元素組成常規微區分析,精確測量元器件尺寸), 日本電子
4 EMMI微光顯微鏡/OBIRCH鐳射光束誘發阻抗值變化測試/LC 液晶熱點偵測(這三者屬于常用漏電流路徑分析手段,尋找發熱點,LC要借助探針臺,示波器)
5 FIB 線路修改,切線連線,切點觀測,TEM制樣,精密厚度測量等
6 Probe Station 探針臺/Probing Test 探針測試,ESD/Latch-up靜電放電/閂鎖效用測試(有些客戶是在芯片流入客戶端之前就進行這兩項可靠度測試,有些客戶是失效發生后才想到要篩取良片送驗)這些已經提到了多數常用手段。失效分析前還有一些必要的樣品處理過程。
7 取die,decap(開封,開帽),研磨,去金球 De-gold bump,去層,染色等,有些也需要相應的儀器機臺,SEM可以查看die表面,SAM以及X-Ray觀察封裝內部情況以及分層失效。
除了常用手段之外還有其他一些失效分析手段,原子力顯微鏡AFM ,二次離子質譜 SIMS,飛行時間質譜TOF - SIMS ,透射電鏡TEM , 場發射電鏡,場發射掃描俄歇探針, X 光電子能譜XPS ,L-I-V測試系統,能量損失 X 光微區分析系統等很多手段,不過這些項目不是很常用。
FA步驟:
1 非破壞性分析:主要是超聲波掃描顯微鏡(C-SAM)--看有沒delamination,xray--看內部結構,等等;
2 電測:主要工具,萬用表,示波器,sony tek370a,現在好象是370b了;
3 破壞性分析:機械decap,化學 decap芯片開封機
半導體器件芯片失效分析 芯片內部分層,孔洞氣泡失效分析
C-SAM的叫法很多有,掃描聲波顯微鏡或聲掃描顯微鏡或掃描聲學顯微鏡或超聲波掃描顯微鏡(Scanning acoustic microscope)總概c-sam(sat)測試。
微焦點Xray用途:半導體BGA,線路板等內部位移的分析 ;利于判別空焊,虛焊等BGA焊接缺陷. 參數:標準檢測分辨率<500納米 ; 幾何放大倍數: 2000 倍 最大放大倍數: 10000倍 ; 輻射小: 每小時低于1 μSv ; 電壓: 160 KV, 開放式射線管設計防碰撞設計;BGA和SMT(QFP)自動分析軟件,空隙計算軟件,通用缺陷自動識別軟件和視頻記錄。這些特點非常適合進行各種二維檢測和三維微焦點計算機斷層掃描(μCT)應用。 芯片開封機DECAP主要用于芯片開封驗證SAM,XRAY的結果。



























